
封装技术的进步推动了三维(3D)集成系统的发展。3D集成系统可能对基于标准封装集成技术系统的性能、电源、功能密度和外形尺寸带来显著改善。虽然这些高度集成系统的设计和测试要求仍在不断变化,但很显然先进的测试自动化将对推动3D集成系统的量产产生重要影响。本文将讨论3D集成系统相关的一些主要测试挑战,以及如何通过Synopsys的合成测试解决方案迅速应对这些挑战。
2.5D集成和3D集成
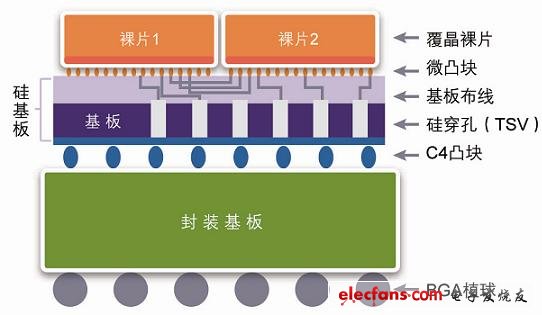
图1:2.5D集成(两块裸片通过穿过硅基板的导线进行互连)。

图2:3D-SIC(两块堆叠裸片通过TSV进行互连)。
对堆叠配置进行测试需要2.5D封装测试所需的自动化的超集,因此在以下章节中我们将重点讨论这一话题。
对3D堆叠IC进行测试
图3显示了由三片裸片堆叠的3D-SIC众多可能测试方法中两种方法的测试场景。一种方法是在所有裸片粘接在一起之后进行堆叠测试,如场景1所示。堆叠测试从底部(第一块)裸片与第二块裸片之间,以及第二块裸片与第三块裸片之间的TSV互连测试开始,然后从底部裸片开始按顺序对每块裸片进行测试。此外,堆叠测试同时还可包括把整个堆叠作为一个集成系统进行测试。

图3:对某个三裸片堆叠进行3D-SIC测试场景举例。在场景1中,只有在所有三块裸片粘接完成之后才进行堆叠测试。在场景2中,每当有一块已知合格裸片粘接到堆叠顶部时都要进行一次堆叠测试。
由于对后续发现存在缺陷的裸片进行“拆除(un-bond)”不太可行,因此在粘接之前对单个IC在粘接过程中的互联可能造成的损失测试可能比仅依赖堆叠测试来识别已造成整个系统缺陷的缺陷裸片更加具有成本效益。在图3的场景2中,每当有一块KGD粘接到IC堆叠顶部时都要进行一次堆叠测试,以便排查对顶部两块裸片以及在粘接过程中的互联可能造成的损失。
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)